2026R1版本更新:新增半导体工艺仿真求解器 DFCD-Plasma
在2026R1新版本中,我们特别推出了聚焦微纳尺度的 DFCD-Plasma 求解器。它专为解决半导体工艺步骤对器件特征尺寸影响的精确仿真而开发。
DFCD-Plasma功能及特点
Plasma通过耦合气相组分输运与表面反应的综合效应,确定随时间变化的生长与刻蚀行为,可模拟任意数量的多步表面反应,以及由化学反应引起的固体材料形状变化。通过引入先进的动理学模型与表面反应机理,DFCD-Plasma 让工程师在虚拟环境中即可完成对原子尺度工艺的探索,大幅缩短先进半导体器件的研发周期。
基于上述核心能力,DFCD-Plasma 在2026R1版本中进一步强化了面向关键工艺场景的工程应用能力,在以下三个维度实现重点突破:
- 沟槽填充预测:模拟化学气相沉积(CVD)或等离子体增强化学气相沉积(PECVD)过程中的材料填充行为,提前判断沟槽是否完全填充或产生空洞,为工艺参数优化提供依据。
- 刻蚀轮廓分析:分析施加的晶圆偏压及相应离子能量对刻蚀速率和轮廓形状的影响,助力高深宽比结构刻蚀工艺的开发。
- 薄膜覆盖模拟:预测在已有复杂结构上进行物理气相沉积(PVD)时薄膜的覆盖情况,保障互连与封装工艺的可靠性。
DFCD-Plasma多尺度模型
DFCD-Plasma与DFCD-MultiFLOW 的耦合,实现宏观—介观—微观多尺度仿真能力,精确模拟薄膜在晶圆表面沉积与刻蚀过程中形成的二维和三维形貌演化,该多尺度仿真框架涵盖以下三个尺度的模型:
- 反应器宏尺度(macro-scale)模型用于预测刻蚀或沉积的生长速率与均匀性,由多物理场求解器DFCD-MultiFLOW实现;
- 鞘层介观尺度(meso-scale)模型关注晶粒尺度上的通量(非)均匀性及等离子体鞘层对体相与表面之间传输过程的影响;
- 特征微尺度(micro-scale)模型用于预测实际制备出的微观结构形貌,验证是否得到了预期的器件结构。
DFCD-Plasma典型应用示例
基于水平集方法(Level Set)表征材料界面与组分通量,采用自适应网格技术,实现对特征几何结构的高分辨率捕捉。
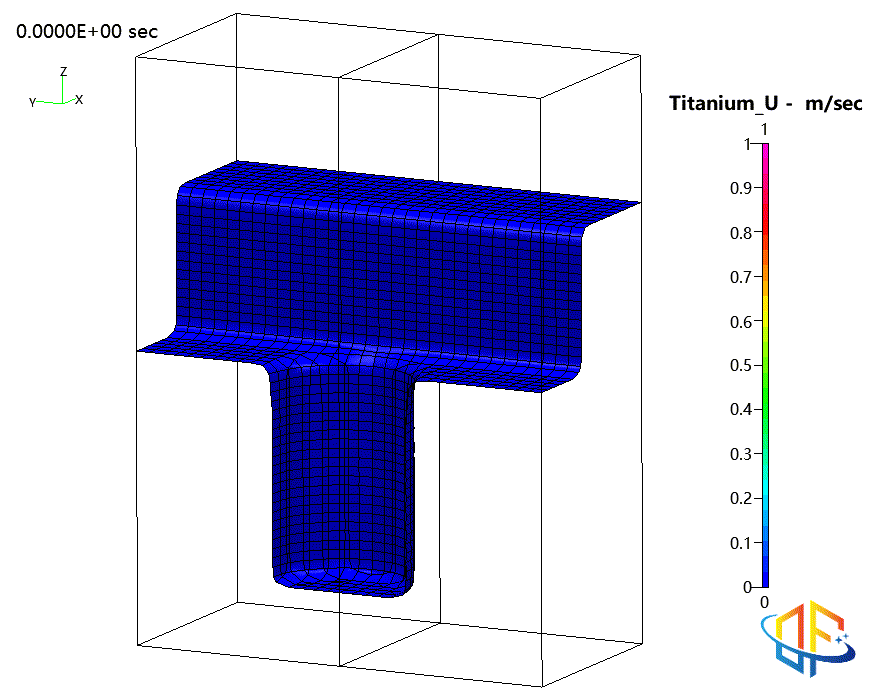
沉积示例

刻蚀示例
在刻蚀过程中,针对两种不同材料的刻蚀模型,每种材料具有独立的反应机理。离子在光刻胶表面以掠射角发生镜面反射(类镜面反射)。未反射的离子通量以吸附系数为1进行线性刻蚀。
这一机理组合导致两种材料的刻蚀速率与轮廓演化呈现差异化特征,其中交界处的耦合效应尤为关键:在光刻胶-硅交界处,由于额外的反射离子通量作用,形成更深的沟槽。
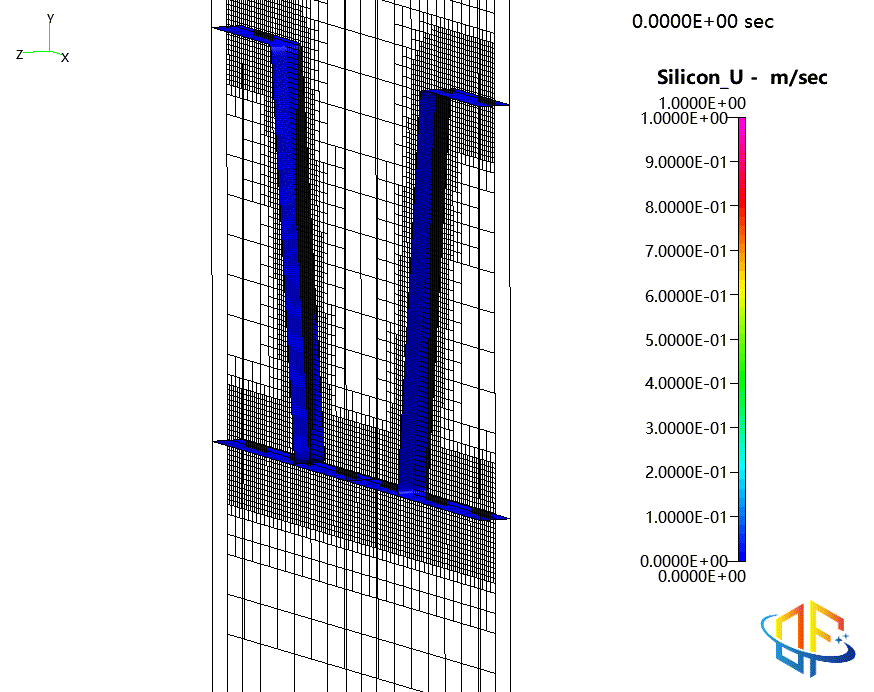
硅的氯基刻蚀工艺

含聚合物形成的二氧化硅刻蚀过程
氧化物与光刻胶表面随时间的演化,按刻蚀速率着色。
2026R1版本功能增强:DFCD-Poly 网格优化再进一步
依托MPI并行技术,本软件实现了大规模网格的快速生成能力。单次任务即可稳定生成5亿级网格单元,满足超大尺度、高精度仿真对网格规模的需求。并行框架充分调度多节点计算资源,将原本串行环境下需数十小时完成的网格生成任务,压缩至2小时左右,大幅提升前处理效率,为后续大规模数值模拟提供可靠支撑。
这一突破使复杂工程模型的离散化不再成为瓶颈,显著提升大型项目(如飞机全机、汽车外流场)的仿真效率与精度,助力研发团队更快获得关键洞察。
不同并行规模下网格生成性能对比
-
测试环境配置
- 处理器: Intel Xeon Gold 6230 @ 2.10GHz (40 内核)
- 内存: 256 GB
- 操作系统: Windows Server 2016
-
性能数据表
- 千万级网格数量
- 亿级网格数量


- 应用案例
家庭用车
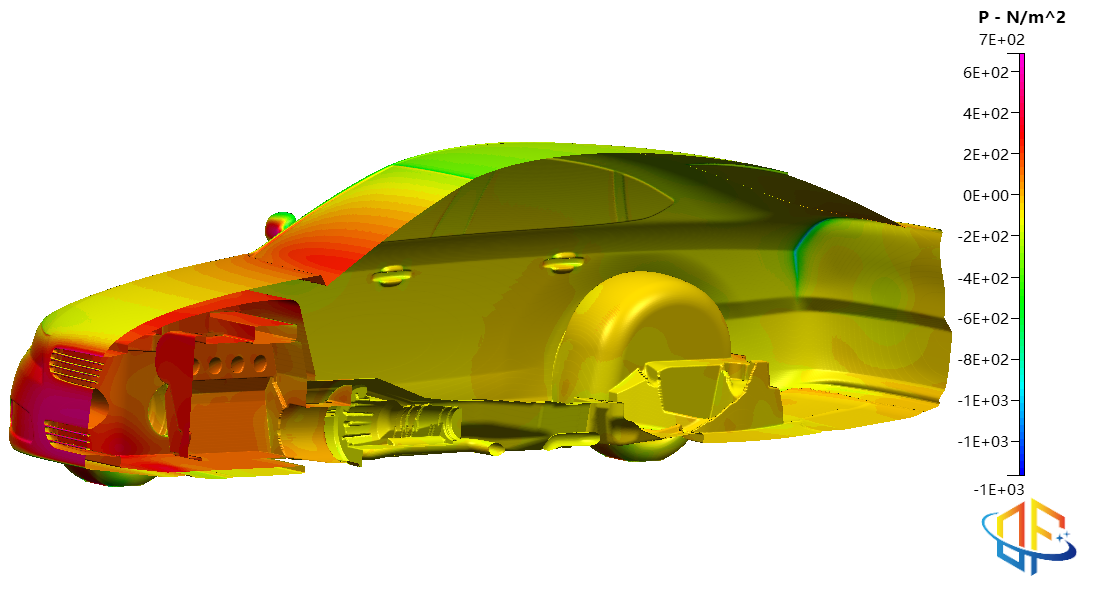

歼击机


2026R1版本性能提升:RhoFLOW 异构计算重构
本次更新对 RhoFLOW 求解器进行了异构计算重构,重点针对线性方程组求解与湍流计算两大耗时模块引入 GPU 并行加速。依托 GPU 数千个计算核心的大规模并行能力,原本由 CPU 串行处理的密集矩阵运算与湍流求解任务被高效拆分、并行执行;CPU 则专注于流程控制、内存管理与非规则计算。通过 CPU + GPU 异构协同,在保持求解精度的前提下,计算耗时显著缩短,大幅提升大规模仿真场景下的求解效率。


